


IGBT散热本质是多层热阻串联下的热量输运效率问题,其中界面热阻占比超60%,是主要优化对象。
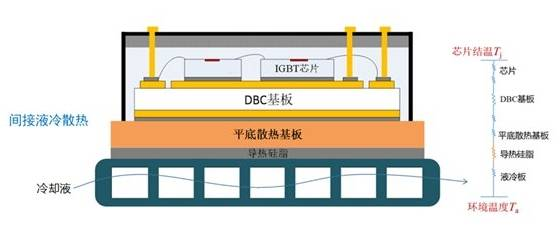
图1:IGBT热阻示意图
1-问题根源:热阻究竟藏在哪里?
IGBT模块的热阻构成是一个复杂的多层结构,涉及多个材料层和热传导路径。IGBT模块的热阻构成主要由IGBT模块的热阻(Rth )由结-壳热阻(Rth-Rjc )和壳-环境热阻( Rth-Rca)串联构成:
a.结-壳热阻(Rth-Rjc ):
· 覆铜陶瓷板是主要瓶颈:占的Rth-Rjc 75%以上,因其陶瓷层(如Al₂O₃)导热率低(15–35 W/m·K)且厚度不可忽略 。
· 其他层级占比:芯片热阻(硅基导热率≈150 W/m·K)、焊料层热阻(空洞导致界面热阻)、铜基板热阻(导热率高但厚度影响小)共同构成剩余25% 。
b.壳-环境热阻(Rth-Rca ):
· 界面接触热阻占主导:基板与散热器间的导热硅脂/接触面热阻占总热阻的40–60%,在单面散热传统设计中占比>60% 。
· 散热结构影响:如风冷散热器中,接触热阻(Rjc)、导热热阻(Rch)、换热热阻(Rha )分别占比65.9%、5.9%、28.2%(常规翅片结构)。
2-热阻攻克路径:材料与结构协同优化
a.芯片减薄:降低内部热阻
· 技术演进:从PT型晶圆200μm减薄至IGBT7的70μm,热阻降低60% 。减薄工艺(研磨/CMP/等离子刻蚀)可释放应力,提升热扩散效率 。
· 物理机制:厚度从350μm降至110μm,单位面积热容(Cth )从786.5 J/℃·m²降至247.2 J/℃·m²,加速瞬态散热 。减薄后电阻减小,欧姆接触增强,降低内应力导致的失效风险 。
b.界面革新:银烧结替代导热硅脂
界面材料升级是降低接触热阻的核心:

表1:银烧结与导热硅脂导热性能对比
c.基板升级:高导热陶瓷与金刚石
基板材料正经历从 Al₂O₃ 到 AlN 再到金刚石的关键演进,核心目标是显著提升热导率,以满足更高功率密度电子器件的散热需求。
· AlN 基板的突破
热导率可达 Al₂O₃ 的 5–10 倍。热膨胀系数 (约 4.5 ppm/K) 更接近硅 (约 2.6 ppm/K),有效降低了与硅芯片间的热失配应力。
· 金刚石基板前景: 热导率超2000 W/(m·K)(Al₂O₃的80倍),热膨胀系数1.1 ppm/K,完美匹配硅芯片。金刚石/铝复合材料热导率达613 W/(m·K)(纯铝2.6倍),界面优化提升结合强度。
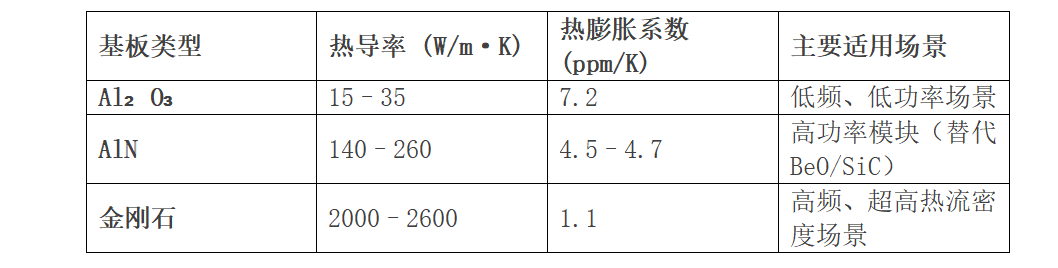
表2:关键基板材料性能对比
3-热阻攻克挑战
a.芯片减薄的机械强度瓶颈
厚度从200μm降至70μm(IGBT7)可降热阻60%,但继续减薄至20μm将引发断裂风险。超薄芯片(<50μm)因热膨胀系数(CTE)失配易产生微裂纹。
b.高导热基板挑战
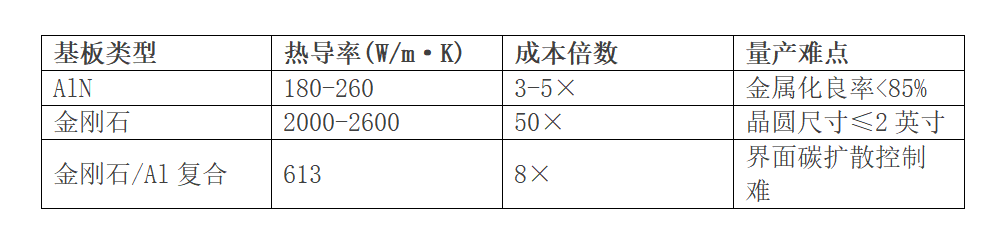
表3:高导热基板挑战
c.界面可靠性:多物理场耦合挑战
·银烧结CTE失配风险:银烧结层(CTE=18.4 ppm/K)与SiC芯片(CTE=4.5 ppm/K)差异达4倍,热循环易分层。
·界面接触压力控制:压力0.1→0.5 MPa可降热阻40%,但>1 MPa会挤出银层。
当IGBT功率密度迈入10kW/cm²时代,散热设计已从「辅助工程」跃升为「系统瓶颈破局点」。从Al₂O₃到金刚石的基板革命、从硅脂到铜烧结的界面跃迁、从200μm到50μm的芯片瘦身,本质上是一场对抗热力学第二定律的攻坚战。散热设计逼近物理极限,材料-结构-工艺三角协同将成为破局关键。
我们会定期更新有关热设计与轻量化的技术与资讯,与您分享,供您参考,感谢您对迈泰的关注。